- Deutsch
-
EnglishDeutschItaliaFrançais日本語한국의русскийSvenskaNederlandespañolPortuguêspolskiSuomiGaeilgeSlovenskáSlovenijaČeštinaMelayuMagyarországHrvatskaDanskromânescIndonesiaΕλλάδαБългарски езикAfrikaansIsiXhosaisiZululietuviųMaoriKongeriketМонголулсO'zbekTiếng ViệtहिंदीاردوKurdîCatalàBosnaEuskeraالعربيةفارسیCorsaChicheŵaעִבְרִיתLatviešuHausaБеларусьአማርኛRepublika e ShqipërisëEesti Vabariikíslenskaမြန်မာМакедонскиLëtzebuergeschსაქართველოCambodiaPilipinoAzərbaycanພາສາລາວবাংলা ভাষারپښتوmalaɡasʲКыргыз тилиAyitiҚазақшаSamoaසිංහලภาษาไทยУкраїнаKiswahiliCрпскиGalegoनेपालीSesothoТоҷикӣTürk diliગુજરાતીಕನ್ನಡkannaḍaमराठी
Bedrohung für TSMCs Cowos?Experten behaupten, Glassubstrate werden 2.5D -Chipverpackungen ersetzen
Professor Yong-Won Lee vom Georgia Institute of Technology in den USA, der sich auf fortschrittliche Verpackungstechnologie spezialisiert hat, kürzlich auf einer Industriekonferenz in Seoul angegeben, dass Glass-Substrate einen klaren Zielmarkt haben.Sie sind in High-End-Segmenten des Chip-Marktes wie künstliche Intelligenz (KI) und Serverchips zu verwenden.
Cowos ist die 2.5D -Verpackungstechnologie von TSMC, bei der Chips wie CPUs, GPUs, I/OS und Hochbandbreitengedächtnis (HBM) auf einem Interposer vertikal gestapelt sind.Die A100 und H100 von NVIDIA sowie Gaudi von Intel werden mit dieser Technologie hergestellt.
Glassubstrate werden als Zukunft der Verpackungssubstrate angepriesen und es wird erwartet, dass sie das weit verbreitete Flip-Chip-Grid-Array (FC-BGA) ersetzen.
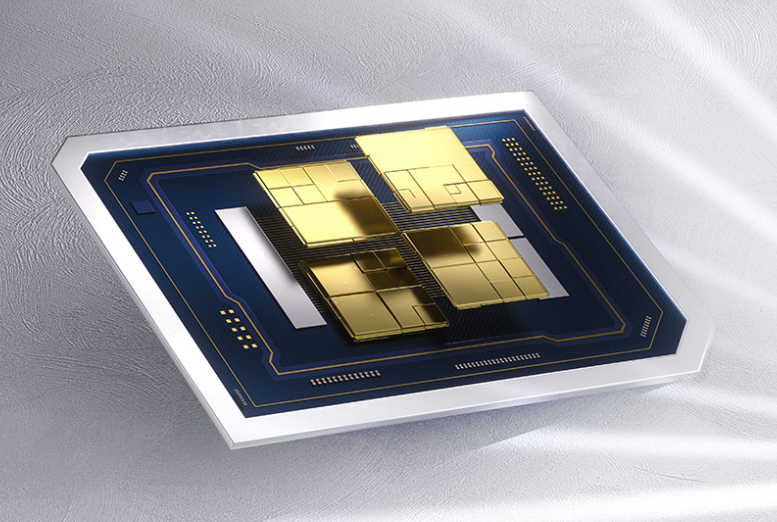
Mit dem Kernsubstrat aus Harzglas anstelle von herkömmlichen Materialien bietet es Vorteile in Bezug auf die Oberflächentrennung, die Gleichmäßigkeit der Verbindung und die Chipausrichtung.
Es wird auch erwartet, dass Glassubstrate Verpackungssubstrate über 100 x 100 mm einführen, sodass mehr Chips verpackt werden können.
Zu den Unternehmen, die diese Technologie untersuchen, gehören Intel, Absolics, Samsung Electro-Mechanics, DNP und idaden.
Absolics, ein Joint Venture zwischen SKC und angewandten Materialien, startete kürzlich in seinem Werk in Georgia, um im nächsten Jahr kommerzielle Produktion zu produzieren.
Professor Yong-Won Lee erklärte, dass Glassubstrate im Gegensatz zu Cowos ohne Interposer Soc- und HBM-Chips montieren können, was bedeutet, dass mehr Chips in geringerer Höhe montiert werden können.
Im Mai dieses Jahres präsentierte das Georgia Institute of Technology ein Papier auf der Konferenz der IEEE 74. Electronic Components Technology in Colorado 2024, wo sie 60 Chips auf einem Glassubstrat (6 XPU6 -Einheiten, 54 HBM -Einheiten) montierten.Dies bedeutet, dass es 3,7-mal mehr Chips als die Cowos-R-Technologie von TSMC auf derselben Konferenz hatte.
