- Deutsch
-
EnglishDeutschItaliaFrançais日本語한국의русскийSvenskaNederlandespañolPortuguêspolskiSuomiGaeilgeSlovenskáSlovenijaČeštinaMelayuMagyarországHrvatskaDanskromânescIndonesiaΕλλάδαБългарски езикAfrikaansIsiXhosaisiZululietuviųMaoriKongeriketМонголулсO'zbekTiếng ViệtहिंदीاردوKurdîCatalàBosnaEuskeraالعربيةفارسیCorsaChicheŵaעִבְרִיתLatviešuHausaБеларусьአማርኛRepublika e ShqipërisëEesti Vabariikíslenskaမြန်မာМакедонскиLëtzebuergeschსაქართველოCambodiaPilipinoAzərbaycanພາສາລາວবাংলা ভাষারپښتوmalaɡasʲКыргыз тилиAyitiҚазақшаSamoaසිංහලภาษาไทยУкраїнаKiswahiliCрпскиGalegoनेपालीSesothoТоҷикӣTürk diliગુજરાતીಕನ್ನಡkannaḍaमराठी
Email:Info@Y-IC.com
Zuhause > Nachrichten > Die Industrie sagt, dass Apple's M1 Ultra Chip TSMCs Cowos-S-Verpackungstechnologie verwendet
Die Industrie sagt, dass Apple's M1 Ultra Chip TSMCs Cowos-S-Verpackungstechnologie verwendet
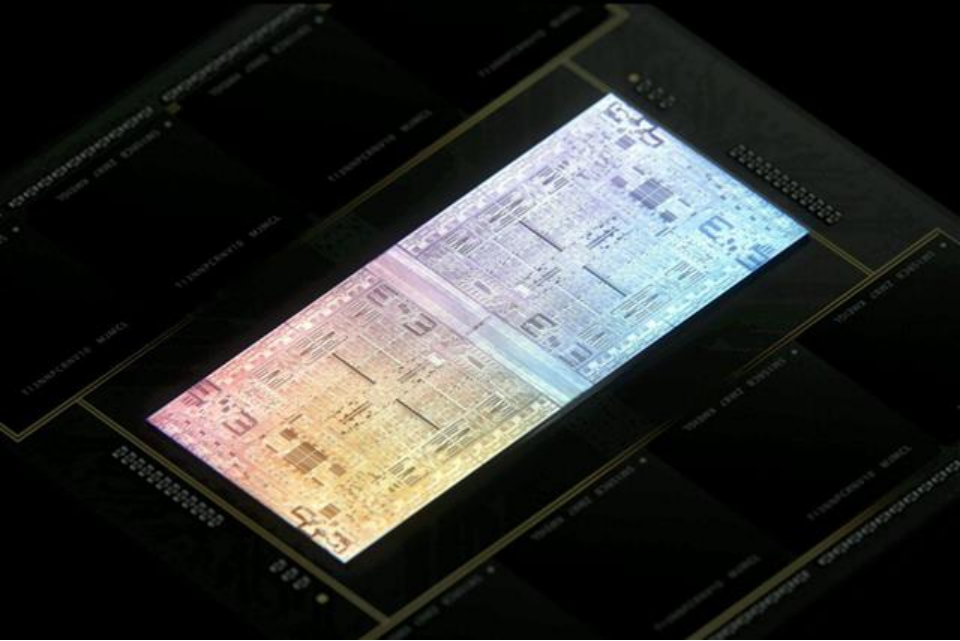
Laut Industriequellen hat Apple seinen M1-Ultra-SOC gerade veröffentlicht, der die inhouse entwickelte Ultrafusionsverpackungsarchitektur verwendet und von TSMC mit dem 5NM-Prozessknoten und der fortschrittlichen Verpackungstechnologie hergestellt wird. Die erforderliche ABF-Trägerplatte wird vollständig von Xinxing-Elektronik bereitgestellt.
Quellen nach Digitimes, dass die innovative Verpackungsarchitektur von Apple ein Silizium-Interposer verwendet, um zwei M1-Max-Chips anzuschließen, um einen System-on-Chip (SOC), einem 2.5D-Verpackungsmodell zu erstellen, das möglicherweise in den Mac Pro-Kernchip passen kann.
Um das Risikomanagement zu verbessern, setzt Apple auf TSMC auf, um seine neuesten M1-Produkte herzustellen, wobei die Quellen mit fortschrittlichen Lösungen mithilfe von fortschrittlichen Lösungen, die die 5nm-Chip-Technologie und das Cowos-S (Chip-on-Wafer-on----------------Substrat mit Silicon-Interposer) integrieren, integrieren.
Die Person wies darauf hin, dass TSMC umfangreiche Erfahrung in der Nutzung seiner Cowos-Verpackungs-Plattform hat, um verschiedene Chiplösungsanbieter wie Netzwerk-ICs und ultra-große AI-Chips zu bedienen. TSMC stellt auch iPhone-APS mit fortschrittlichen Prozessknoten und info_pop-Technologie her her.
Als Apple weiterhin das hauseigene Chip-Design vorantreiben, wird es immer mehr nach fortgeschrittenen Verpackungslösungen benötigen, und TSMC wird mit mehr 3D-Fabric-Plattformen eine zunehmend wichtigere Rolle spielen. Sogar Chip-Probing ist einer der integrierten Dienste für die Gießerei zukünftiger Apple Silicon-Produkte, die Quelle hinzugefügt.
Die Quelle wies auch darauf hin, dass Xinxing-Elektronik derzeit der einzige Anbieter von ABF-Trägerkarten der M1-Serie ist, und M1 Ultra bleibt kurzfristig, da Xinxing Electronics jetzt das einzige Unternehmen, das sich treffen kann Apples Fertigungstechnologieanforderungen. und IC-Substrathersteller mit Kapazitätsanforderungen.
Berichten zufolge stellt Südkoreas LG Innotek ABF-Carrier-Boards für Apples Automotive-Anwendungen zur Verfügung, und die AT & S, Taiwans Jingshuo Technology und Zhending-Technologie können die Möglichkeit haben, ABF-Carrier-Boards für M1-Ultra-Produkte bereitzustellen.
Quellen sagen, dass das M1-Ultra-ABF-Trägerplatine doppelt so groß ist, dass der Bereich M1 Max benötigt wird, der den Umsatz für Lieferanten steigern wird, aber die m1 ultrabetriebene MAC-Linie ist an Künstlern und Ersteller angestrebt, und die tatsächliche Freisetzung wird anfänglich nicht die Menge sein sehr groß.
Zu diesem Zweck müssen XINXING ELECTRONICS und andere Kollegen technologische Upgrades auftreten, um fortschrittlichere ABF-Substrate zu entwickeln, die für die bevorstehende 3NM-Chip-Produktion erforderlich sind, die weiterhin etwa 70 Prozent der fortgeschrittenen ABF-Substrate dominiert, die hinzugefügte Person. Die Verpackungsanwendungen, obwohl es auch einen möglichen Trend gibt, nimmt die Verpackung von Waferebene ohne Träger allmählich an.
Quellen nach Digitimes, dass die innovative Verpackungsarchitektur von Apple ein Silizium-Interposer verwendet, um zwei M1-Max-Chips anzuschließen, um einen System-on-Chip (SOC), einem 2.5D-Verpackungsmodell zu erstellen, das möglicherweise in den Mac Pro-Kernchip passen kann.
Um das Risikomanagement zu verbessern, setzt Apple auf TSMC auf, um seine neuesten M1-Produkte herzustellen, wobei die Quellen mit fortschrittlichen Lösungen mithilfe von fortschrittlichen Lösungen, die die 5nm-Chip-Technologie und das Cowos-S (Chip-on-Wafer-on----------------Substrat mit Silicon-Interposer) integrieren, integrieren.
Die Person wies darauf hin, dass TSMC umfangreiche Erfahrung in der Nutzung seiner Cowos-Verpackungs-Plattform hat, um verschiedene Chiplösungsanbieter wie Netzwerk-ICs und ultra-große AI-Chips zu bedienen. TSMC stellt auch iPhone-APS mit fortschrittlichen Prozessknoten und info_pop-Technologie her her.
Als Apple weiterhin das hauseigene Chip-Design vorantreiben, wird es immer mehr nach fortgeschrittenen Verpackungslösungen benötigen, und TSMC wird mit mehr 3D-Fabric-Plattformen eine zunehmend wichtigere Rolle spielen. Sogar Chip-Probing ist einer der integrierten Dienste für die Gießerei zukünftiger Apple Silicon-Produkte, die Quelle hinzugefügt.
Die Quelle wies auch darauf hin, dass Xinxing-Elektronik derzeit der einzige Anbieter von ABF-Trägerkarten der M1-Serie ist, und M1 Ultra bleibt kurzfristig, da Xinxing Electronics jetzt das einzige Unternehmen, das sich treffen kann Apples Fertigungstechnologieanforderungen. und IC-Substrathersteller mit Kapazitätsanforderungen.
Berichten zufolge stellt Südkoreas LG Innotek ABF-Carrier-Boards für Apples Automotive-Anwendungen zur Verfügung, und die AT & S, Taiwans Jingshuo Technology und Zhending-Technologie können die Möglichkeit haben, ABF-Carrier-Boards für M1-Ultra-Produkte bereitzustellen.
Quellen sagen, dass das M1-Ultra-ABF-Trägerplatine doppelt so groß ist, dass der Bereich M1 Max benötigt wird, der den Umsatz für Lieferanten steigern wird, aber die m1 ultrabetriebene MAC-Linie ist an Künstlern und Ersteller angestrebt, und die tatsächliche Freisetzung wird anfänglich nicht die Menge sein sehr groß.
Zu diesem Zweck müssen XINXING ELECTRONICS und andere Kollegen technologische Upgrades auftreten, um fortschrittlichere ABF-Substrate zu entwickeln, die für die bevorstehende 3NM-Chip-Produktion erforderlich sind, die weiterhin etwa 70 Prozent der fortgeschrittenen ABF-Substrate dominiert, die hinzugefügte Person. Die Verpackungsanwendungen, obwohl es auch einen möglichen Trend gibt, nimmt die Verpackung von Waferebene ohne Träger allmählich an.
